2018年5月,中芯國際(SMIC)訂購了一套極紫外光刻(EUV)設(shè)備,該設(shè)備來自荷蘭芯片設(shè)備制造商ASML,價值1.2億美元。長江存儲的首臺光刻機同樣來自ASML,為193nm浸潤式光刻機,售價7200萬美元,用于14 nm-20 nm工藝。
12月3日晚,荷蘭光刻機巨頭ASML的元器件供應(yīng)商——Prodrive突發(fā)大火,ASML預(yù)計這場火災(zāi)可能會影響到2019年年初的出貨計劃。2019年5月24日,中芯國際(SMIC)發(fā)公告稱將其美國預(yù)托證券股份從紐約證券交易所退市,大家都目光關(guān)注到它的14nm量產(chǎn)進程。隨著中國半導(dǎo)體制造的崛起與壯大,光刻機作為核心設(shè)備貫穿近幾年大眾的熱點,多次被引發(fā)討論。

2018年全球光刻機出貨逾600臺,較2017年的460臺增幅達30%。其中,ASML、Nikon、Canon三巨頭半導(dǎo)體用光刻機在2018年出貨374臺,較2017年的294臺增加80臺,增長27.21%。2018年ASML、Nikon、Canon三巨頭光刻機總營收118.92億歐元,較2017年增長25.21%。從EUV、ArF immersion、ArF機型的出貨來看,全年共出貨134臺。其中ASML出貨120臺,占有9成的市場。
ASML
2018年ASML光刻機出貨224臺,營收達82.76億歐元,較2017年成長35.74%。其中EUV光刻機營收達18.86億歐元,較2017年增加7.85億歐元。
Nikon
2018年度(非財年),Nikon光刻機出貨106臺,營收達20.66億歐元,較2017年成長25.29%。2018年度,Nikon半導(dǎo)體用光刻機出貨36臺,比2017年度增加9臺,增長33.33%。其中ArFimmersion光刻機出貨5臺,較2017年度減少1臺;ArF光刻機出貨9臺,較2017年度增加1臺;KrF光刻機出貨5臺,較2017年度增加3臺;i-line光刻機出貨17臺,較2017年度增加6臺。2018年度,Nikon半導(dǎo)體用光刻機出貨36臺中,其中全新機臺出貨19臺,翻新機臺出貨17臺。值得一提的是,2018年度,Nikon面板(FPD)用光刻機出貨70臺。
Canon
2018年Canon光刻機出貨183臺,營收達15.5億歐元,較2017年微增1.6%。2018年Canon半導(dǎo)體用光刻機出貨達114臺,較2017年增加44臺,增長62.85%。但是主要是i-line、KrF兩個低端機臺出貨。2018年全年面板(FPD)用光刻機出貨69臺。
02
光刻機的發(fā)展
1、前EUV時代
光刻機分為紫外光源(UV)、深紫外光源(DUV)、極紫外光源(EUV)。按照發(fā)展軌跡,最早的光刻機光源即為汞燈產(chǎn)生的紫外光源(UV)。之后行業(yè)領(lǐng)域內(nèi)采用準(zhǔn)分子激光的深紫外光源(DUV),將波長進一步縮小到ArF的193 nm。由于遇到了技術(shù)發(fā)展障礙,ArF加浸入技術(shù)成為主流。
浸入技術(shù)是指讓鏡頭和硅片之間的空間浸泡于液體之中。由于液體的折射率大于1,使得激光的實際波長會大幅度縮小。目前主流采用的純凈水的折射率為1.44,所以ArF加浸入技術(shù)實際等效的波長為193 nm/1.44=134 nm,從而實現(xiàn)更高的分辨率。
由于157 nm波長的光線不能穿透純凈水,無法和浸入技術(shù)結(jié)合。因此,準(zhǔn)分子激光光源只發(fā)展到了ArF。通過浸沒式光刻和雙重光刻等工藝,第四代 ArF 光刻機最高可以實現(xiàn) 22nm 制程的芯片生產(chǎn),但是在摩爾定律的推動下,半導(dǎo)體產(chǎn)業(yè)對于芯片制程的需求已經(jīng)發(fā)展到 14nm、 10nm、甚至7nm, ArF 光刻機已無法滿足這一需求,半導(dǎo)體產(chǎn)業(yè)將希望寄予第五代 EUV 光刻機。

2、EUV時代
為了提供波長更短的光源,極紫外光源(EUV)為業(yè)界采用。目前主要采用的辦法是將二氧化碳激光照射在錫等靶材上,激發(fā)出13.5 nm的光子,作為光刻機光源。目前僅有由荷蘭飛利浦公司發(fā)展而來的ASML(阿斯麥)一家可提供可供量產(chǎn)用的EUV光刻機,因此ASML對于EUV光刻機的供貨重要性不言而喻,同時一臺EUV光刻機也是價值不菲。
ASML作為芯片加工設(shè)備光刻機的第一強者,目前占據(jù)全球大部分市場份額,只有日本的兩家光刻機公司(尼康和佳能)稍有競爭的潛能,但也只是占據(jù)很小的市場份額。即便是科技最發(fā)達的美國,目前也不能獨自完整生產(chǎn)出光刻機,只能參與控股ASML。
03
光刻機的構(gòu)造解析
光刻機的構(gòu)造,一般分為:照明系統(tǒng)(光源+產(chǎn)生均勻光的光路),Stage系統(tǒng)(包括Reticle Stage和Wafer Stage),鏡頭組(這個是光刻機的核心),搬送系統(tǒng)(Wafer Handler+ Reticle Handler),Alignment系統(tǒng)(WGA,LSA, FIA)。另外半導(dǎo)體光刻機的工作溫度必須保持在23度,要保證wafer在恒溫和無particle的環(huán)境,必須要有恒溫和控制particle、ESD的工作chamber。

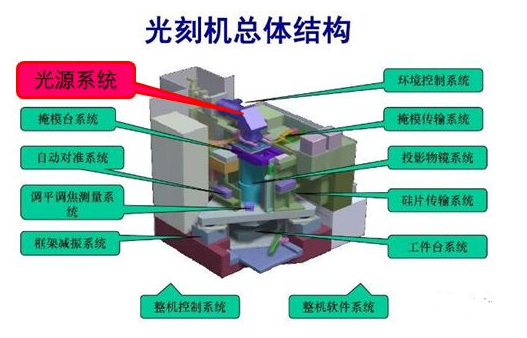
光刻機性能指標(biāo):
光刻機的主要性能指標(biāo)有:支持基片的尺寸范圍,分辨率、對準(zhǔn)精度、曝光方式、光源波長、光強均勻性、生產(chǎn)效率等。

光刻機的原理就是用光來投射到reticle上產(chǎn)生衍射,然后鏡頭收集到光匯聚到wafer上,形成圖形,所以光是產(chǎn)生圖形的必要條件。光刻機主要技術(shù)指標(biāo)準(zhǔn)分子激光器掃描步進投影光刻機最關(guān)鍵的三項技術(shù)指標(biāo)是:光刻分辨率(Resolution)、套刻精度(Overlay)和產(chǎn)能(Productivity)。
光刻分辨率的計算公式為:CD=K1?λ/NA
式中λ為準(zhǔn)分子激光器輸出激光波長,K1為工藝系數(shù)因子,NA為投影光刻物鏡數(shù)值孔徑。從上式可以看出,提高光刻分辨率可以通過縮短激光波長、降低工藝系數(shù)因子K1和提高投影光刻物鏡數(shù)值孔徑NA等來實現(xiàn)。
縮短激光波長將涉及到激光器、光學(xué)系統(tǒng)設(shè)計、光學(xué)材料、光學(xué)鍍膜、光路污染以及曝光抗蝕劑等系列技術(shù)問題;低工藝系數(shù)因子K1值成像,只有當(dāng)掩模設(shè)計、照明條件和抗蝕劑工藝等同時達到最佳化才能實現(xiàn),為此需要采用離軸照明、相移掩模、光學(xué)鄰近效應(yīng)校正、光瞳濾波等系列技術(shù)措施;投影光刻物鏡的數(shù)值孔徑則與激光波長及光譜帶寬、成像視場、光學(xué)設(shè)計和光學(xué)加工水平等因素有關(guān)。
套刻精度與光刻分辨率密切相關(guān)。如果要達到0.10μm的光刻分辨率,根據(jù)33%法則要求套刻精度不低于0.03μm。套刻精度主要與工件臺和掩模臺定位精度、光學(xué)對準(zhǔn)精度、同步掃描精度等因素有關(guān),定位精度、對準(zhǔn)精度和同步掃描精度分別約為套刻精度的1/5~1/3,即0.006~0.01μm。
提高生產(chǎn)效率是光刻機實現(xiàn)產(chǎn)業(yè)化的必要條件。為了提高生產(chǎn)效率,必須優(yōu)化設(shè)計激光器輸出功率、重復(fù)頻率、曝光能量控制、同步掃描等各個技術(shù)環(huán)節(jié),并采用先進技術(shù)盡量減少換片、步進和光學(xué)對準(zhǔn)等環(huán)節(jié)所需時間。由此可見,首先必須先要有可靠的光源系統(tǒng),才能確保光刻機的有效運行。
04
光源系統(tǒng)的發(fā)展
早期stepper式光刻機都是用汞燈做光源,最早有1kw,2kw到最后發(fā)展到了5kw,越來越恐怖。后來為了提高分辨率,采用了新的光源:laser,分為Krf(248nm)和Arf(193nm),laser也是不斷在增加功率,現(xiàn)在最高的可以達到500kw級別了(非常恐怖的激光能量)。
為什么要發(fā)展大功率的汞燈和激光呢?這是產(chǎn)能的需求,在相同的曝光量下,光源的功率越高,曝光需要的時間越少,這樣單位時間里面產(chǎn)能越高。汞燈發(fā)出的光向各個方向擴散,我們需要把光匯聚起來,達到大光強的目的,這時候一個橢圓鏡是必須的了。
我們知道橢圓有兩個焦點,我們把光源放到一個焦點上,那么光就會聚到另外一個焦點上,那就是快門的位置。同時這個橢圓鏡還有另外一個功能,吸收不需要的光線。這種鏡子上有一層涂層,一般500nm以上的紅外光不被反射,而是被吸收。這些光會被產(chǎn)生熱量,所以裝汞燈的地方一定需要一個散熱的東西,功率小一點的就用風(fēng)扇吹,功率大的話就水冷了。反射出來的光也不是全部需要的,我們只需要365nm(I-line)或者436nm(G-line)的波長,別的波長的光也是要淘汰的,這時候filter就上場了,它的作用就是過濾掉不要的東西,只讓需要的波長的光通過。
激光作為光源就不需要上面的這些東西了,因為從激光器里面出來的光已經(jīng)是很純的了,不需要再過濾。然后通過鏡片組將光均勻化。這樣,才能源源不斷的給光刻機合格的光源。
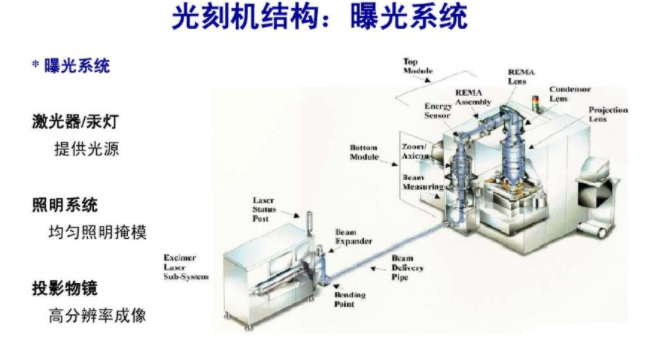
1、最初的兩代光刻機:采用汞燈產(chǎn)生的 436nm g-line 和 365nm i-line 作為光刻光源,可以滿足0.8-0.35 微米制程芯片的生產(chǎn)。最早的光刻機采用接觸式光刻,即掩模貼在硅片上進行光刻,容易產(chǎn)生污染,且掩模壽命較短。此后的接近式光刻機對接觸式光刻機進行了改良,通過氣墊在掩模和硅片間產(chǎn)生細小空隙,掩模與硅片不再直接接觸,但受氣墊影響,成像的精度不高。
2、第三代光刻機:采用 248nm 的 KrF(氟化氪)準(zhǔn)分子激光作為光源,將最小工藝節(jié)點提升至350-180nm 水平,在光刻工藝上也采用了掃描投影式光刻,即現(xiàn)在光刻機通用的,光源通過掩模,經(jīng)光學(xué)鏡頭調(diào)整和補償后,以掃描的方式在硅片上實現(xiàn)曝光。
3、第四代 ArF 光刻機:最具代表性的光刻機產(chǎn)品。第四代光刻機的光源采用了 193nm 的 ArF(氟化氬)準(zhǔn)分子激光,將最小制程一舉提升至 65nm 的水平。第四代光刻機是目前使用最廣的光刻機,也是最具有代表性的一代光刻機。由于能夠取代 ArF 實現(xiàn)更低制程的光刻機遲遲無法研發(fā)成功,光刻機生產(chǎn)商在 ArF 光刻機上進行了大量的工藝創(chuàng)新,來滿足更小制程和更高效率的生產(chǎn)需要。
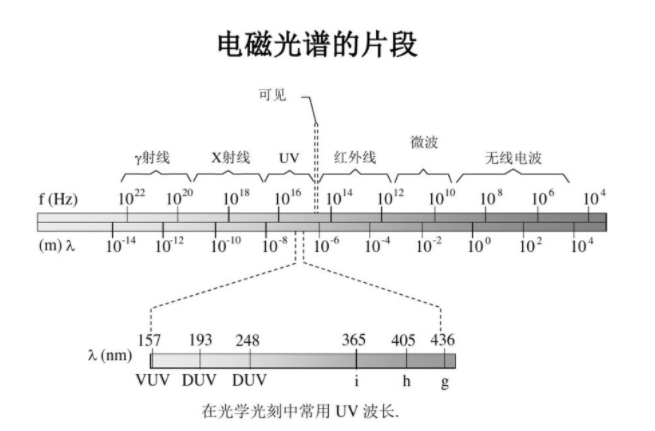
4、第五代EUV光刻機:ASML光刻機可以使用波長為13.5納米的極紫外光(EUV),實現(xiàn)14納米、10納米、和7納米制程的芯片生產(chǎn),而通過技術(shù)升級,也可以實現(xiàn)9納米,8納米,6納米,5納米,4納米乃至3納米等制程的芯片生產(chǎn)。獲取波長為13.5nm的光是實現(xiàn)EUV光刻的一個重要步驟。激光等離子體(Laser-produced Plasma)極紫外光源(LPP-EUV光源)由于其功率可拓展的特性,成為了EUV光刻最被看好的高功率光源解決方案。
EUV 光刻機面市時間表的不斷延后主要有兩大方面的原因,一是所需的光源功率遲遲無法達到 250 瓦的工作功率需求,二是光學(xué)透鏡、反射鏡系統(tǒng)對于光學(xué)精度的要求極高,生產(chǎn)難度極大。這兩大原因使得 ASML及其合作伙伴難以支撐龐大的研發(fā)費用。2012 年 ASML 的三大客戶三星、臺積電、英特爾共同向 ASML 投資 52.59 億歐元,用于支持 EUV 光刻機的研發(fā)。此后 ASML 收購了全球領(lǐng)先的準(zhǔn)分子激光器供應(yīng)商 Cymer,并以 10 億歐元現(xiàn)金入股光學(xué)系統(tǒng)供應(yīng)商卡爾蔡司,加速EUV 光源和光學(xué)系統(tǒng)的研發(fā)進程,這兩次并購也是 EUV 光刻機能研發(fā)成功的重要原因。
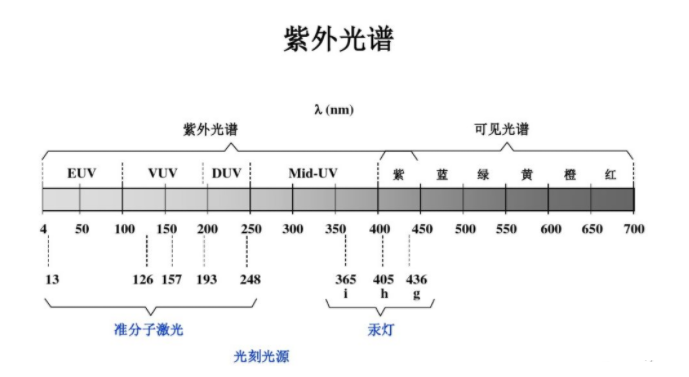
05
EUV光源系統(tǒng)
1、EUV光源系統(tǒng)的組成
EUV光源由光的產(chǎn)生、光的收集、光譜的純化與均勻化三大單元組成。相關(guān)的工作元器件主要包括大功率CO2激光器、多層涂層鏡、負載、光收集器、掩膜版、投影光學(xué)系(Xe或Sn)形成等離子體,等離子利用多層膜反射鏡多次反射凈化能譜,獲得13.5nm的EUV光。


光的產(chǎn)生:CO2激光器,一般采用TRUMPF(原美國大通激光)或者Mitsubishi electronic研制的激光發(fā)射器。
光的收集:極紫外光的波長為 13.5nm,這種光容易被包括鏡頭玻璃內(nèi)的材料吸收,所以需要使用反射鏡來代替透鏡;普通打磨鏡面的反射率還不夠高,必須使用布拉格反射器(Bragg Reflector,一種復(fù)式鏡面設(shè)計,可以將多層的反射集中成單一反射)。此外,氣體也會吸收 EUV并影響折射率,所以腔體內(nèi)必須采用真空系統(tǒng)。
EUV光的收集難度極大,因此轉(zhuǎn)化效率也很低,這也是為什么EUV如此耗電的原因之一。這種光非常容易被吸收,連空氣都不透光,所以整個生產(chǎn)環(huán)境必須抽成真空;同時,也無法以玻璃透鏡折射,必須以硅與鉬制成的特殊鍍膜反射鏡,來修正光的前進方向,而且每一次反射仍會損失 3 成能量,但一臺 EUV 機臺得經(jīng)過十幾面反射鏡,將光從光源一路導(dǎo)到晶圓,最后大概只能剩下不到 2%的光線。反射鏡的制造難度非常大,精度以皮米計(萬億分之一米),如果反射鏡面積有德國那么大(大概是山東、河南兩省面積之和),最高的突起不能超過1厘米。

光的純化與均一化:激光器里面出來的光已經(jīng)是很純的了,所以基本不需要再過濾。但我們不僅需要很純的光,還需要均勻的光,這樣投射到wafer上不會造成各個地方的CD不一致。誰來擔(dān)當(dāng)這個重任呢?
各個廠家用的都不一樣,Nikon是一種叫fly-eye的鏡頭。這種鏡片用很多塊凸透鏡組成,光打到上面就會在各個地方產(chǎn)生匯聚的作用,這樣在relay lens的幫助下,一個平行的均勻的光產(chǎn)生了。
ASML用的是一種叫quad-rod的玻璃長方體,光在里面反射很多次,最后出來的光就被均勻化了。有了均勻的光,我們就可以拿來曝光用,可是有時候我們不需要全部視場大小的光,可能只要曝光一個很小的區(qū)域,這時候用于擋光的機構(gòu),Nikon叫blind, ASML叫REMA的東西就用上了,他們都是上下左右四塊擋片,用馬達帶動,需要多大的區(qū)域只要讓馬達帶動擋片,把不要的光遮住,這樣就可以曝光我們需要的地方了。
最后,通過一塊大的lens把光匯聚一下,就可以投射到reticle上進行曝光了。另外,各大巨頭也對lens組進行了創(chuàng)新,比如Nikon有一種變形照明,在光路中加入了一個可以旋轉(zhuǎn)的圓盤,圓盤上有一些用于產(chǎn)生特定圖形的東西,如小sigma,annual等等,有的時候還需要多塊fly-eye來進行光的處理。
在ASML的光路里,又會有很多負責(zé)產(chǎn)生各種調(diào)整光路的機構(gòu),甚至發(fā)展到最后,需要偏振光等等。越先進,里面的鏡頭組件用的就越多。此外,通過使用OPC(Optical Proximity Correction,光學(xué)鄰近校正)軟件對pattern進行修正,使用緊湊的模型動態(tài)仿真(即基于模型的OPC)的結(jié)果預(yù)先計算出一個查找表,根據(jù)這個查找表來決定怎樣移動圖案的邊緣,從而對光和圖案進行更進一步的處理。
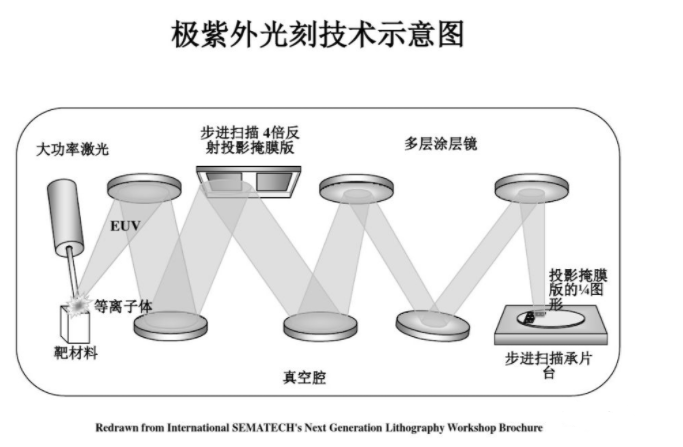
2、EUV光源系統(tǒng)的工作原理
EUV產(chǎn)生工作原理:將高功率的二氧化碳激光打在直徑為30微米的錫液滴上,通過高功率激光蒸發(fā)錫滴,然后將蒸汽加熱到電子脫落的臨界溫度,留下離子,再進一步加熱直到離子開始發(fā)射光子。

(1)錫液發(fā)生器使錫液滴落入真空室③。
(2)脈沖式高功率激光器①擊中從旁飛過的錫液滴②—每秒 50,000 次。Laser分為兩部分,前脈沖和功率放大器。前脈沖和主脈沖擊中錫液使其氣化。 (3)錫原子被電離,產(chǎn)生高強度的等離子體。 (4)收集鏡捕獲等離子體向所有方向發(fā)出的 EUV 輻射,匯聚形成光源。 (5)將集中起來的光源傳遞至光刻系統(tǒng)④以曝光晶片⑤。